高溫燒成類型導電膏
導電膏(CuAgTi系)
產品詳細資訊
產品特點
- 由於金屬膜與基板之間形成穩固的化學接合,對於 Si₃N₄、AlN 基板也具有極佳的附著性。
- 同時具備優異的耐熱性、耐衝擊性、可靠性。
- 透過在上層堆疊銅膏,可形成 0.3 mm以上的超厚膜結構。
- 不含 Pd、Cd 等的有害物質。
產品結構
-
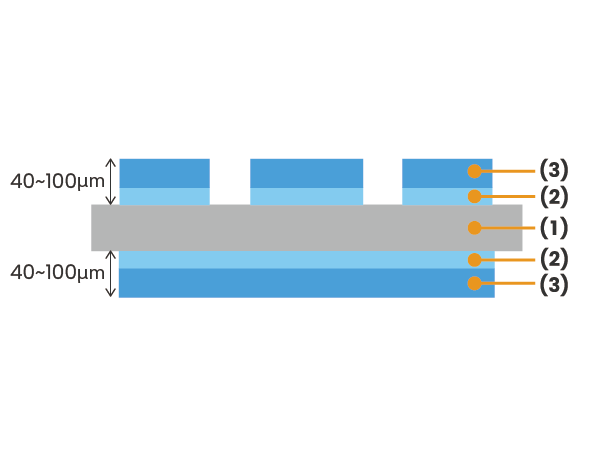
膜厚 100 μm以下
製程
(1) 印刷接合層(AS112)
(2) 印刷接合層上層(DC014GL)
(3) 燒成(例:850 °C,N₂ 環境) -
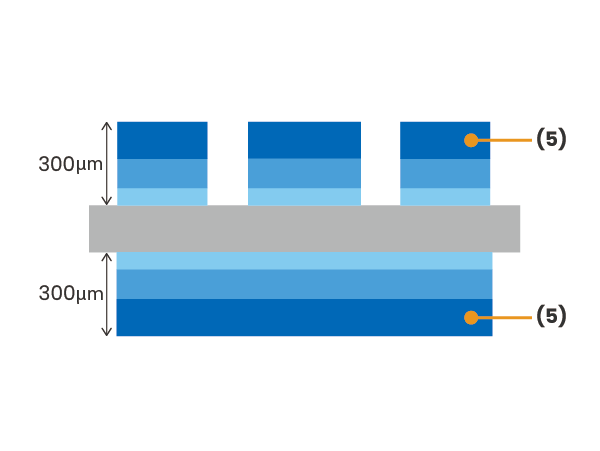
膜厚 100 μm 或以上
膜厚 100 μm 或以上,需追加以下製程。
(4) 印刷增膜層(GL39)
(5)燒成(例:800 °C,N₂ 環境)
-

燒成後基板的照片
使用活性金屬膏作為接合層的銅膏厚膜(50 μm)燒成基板。
(1) 氮化矽
(2) 銅 -
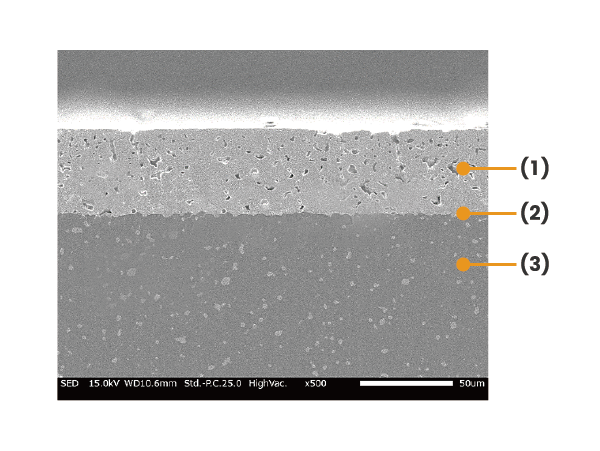
斷面 SEM 影像
接合斷面 SEM 影像
(1) 銅膜
(2) 含活性金屬的接合層 (結構式:Ti₅Si₃)
(3) SiN 基板
應用範例
-
- 功率元件用陶瓷散熱電路封裝
- 需要高可靠性需求的陶瓷電路基板與陶瓷封裝
規格
| 型號 | 膜厚 | 用途 | 特性 | 導體成分 | 接著強度 (N/2mm□) | 建議燒成條件 | 塗佈方式 | 適用基板 | |
|---|---|---|---|---|---|---|---|---|---|
| 100μm< | 100μm≧ | ||||||||
| AS112 | ○ | ○ |
厚膜導體配線、 電極製程(與陶瓷基板接合層) |
高接合強度、 高溫環境下的優異耐久性(高熱可靠性) |
Ag Cu Ti |
≧30 |
850 °C 10min |
網版印刷 | Al₂O₃ AlN Si₃N₄ |
| DC014GL | ○ | ○ |
厚膜導體配線、 電極製程 |
表面平滑性佳、 可透過一次印刷形成較大膜厚 |
Cu | - | 850 °C 10min In N₂ |
網版印刷 | Al₂O₃ AlN Si₃N₄ |
| GL39 | - | ○ |
超厚膜導體配線、 電極製程(積層增膜用) |
可透過一次印刷形成較大膜厚 | Cu | - | 800 °C 10min In N₂ |
網版印刷 | Al₂O₃ AlN Si₃N₄ |
注意事項
- 請在氮氣環境下燒成。
- 使用時的操作注意事項,請遵守各產品的安全資料表 (SDS)。
備註
- 提供燒成服務。若貴司無氮氣置換爐,歡迎洽詢。

